Лазерные технологии в микроэлектронике
Производство микроэлектронных устройств накладывает высокие требования на маркировку: ограничение размера символов и отсутствие какого-либо влияния на окружающий материал. За счет высокой точности и минимальной зоны термического влияния лазер способен маркировать даже самые мелкие детали не повреждая их.
К технологиям лазерной обработки, применяемым в микроэлектронной промышленности, относятся:
-
Маркировка и резка печатных плат / гибких печатных плат
-
Прошивка отверстий различного профиля
-
Маркировка корпусов электронных компонентов
-
Создание топологии поверхности
-
Разделение полупроводниковых пластин
Преимущества лазеров в данной области:
-
Прецизионность (точность до 0,01 мм)
-
Высокая скорость
-
Минимальная зона термического влияния
-
Отсутствие деформаций материала
-
Возможность полной автоматизации процесса
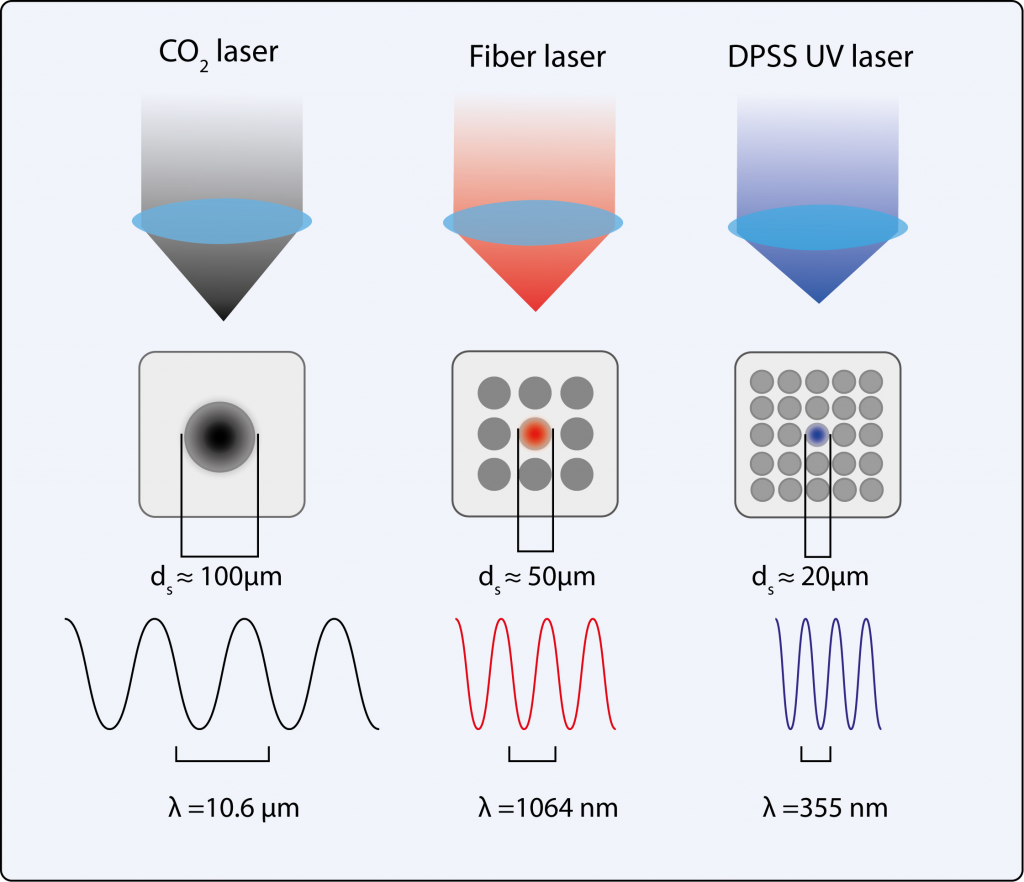
СО2-лазеры могут обеспечить быструю маркировку печатных плат с высокой контрастностью. Однако большой диаметр пятна и значительная зона термического влияния ограничивают минимальный размер маркировки. К тому же излучение ИК-диапазона обладает большой проникающей способностью, чем может повредить проводящие слои печатной платы.
DPSS лазеры (твердотельные лазеры с диодной накачкой) с генерацией гармоник излучают в зеленом или УФ диапазонах. Излучение этих диапазонов лучше поглощается большинством материалов, и, соответственно, имеет меньшую глубину проникновения и небольшую зону термического влияния. Излучение более короткой длины волны фокусируется в пятно меньшего диаметра (дифракционный предел меньше).
Гибкие печатные платы

В гибких печатных платах проводящий слой сформирован в гибком диэлектрике (полиимиде, полиэстере и др.). При их маркировке важно, чтобы лазерное воздействие не вызывало расслоения и карбонизации материала.
Лазерное сверление отверстий в гибких печатных платах – распространенная операция. Использование излучения с длиной волны 10.6 мкм (СО2 лазер) для этой задачи имеет недостатки: воздействие не позволяет получать отверстия диаметром менее 50 мкм, а также полностью отражается медью. Излучение УФ лазера хорошо поглощается всеми материалами гибких печатных плат и позволяет достичь диаметра отверстий до 15 мкм.
Кремниевые пластины

Лазерная маркировка кремниевых пластин облегчает отслеживание при производстве полупроводниковых приборов. Маркировка имеет минимальный размер, она машиночитаема и не оказывает негативного влияния на дальнейшие этапы производства.
LED панели

Маркировка необходима при производстве светодиодов. Такая маркировка машиночитаема, не оказывают негативного влияния на последующие этапы производства и позволяют идентификацию в конце технологической цепочки.
Маркировка корпусов интегральных схем, мощных полупроводниковых приборов, светодиодов высокой яркости, РЧ-устройств и пр. Для маркировки корпусов интегральных схем используются лазеры ИК диапазона, позволяющие выполнять маркировку глубиной в пределах 30 - 50 мкм. Для полупроводниковых устройств с малыми габаритами предпочтительны источники излучения зеленого или УФ диапазона, глубина маркировки которыми составляет менее 10 мкм.
Маркировка подложек интегральных схем
С помощью лазера на подложки интегральных схем наносятся двумерные матричные коды в целях отслеживания и контроля качества продукции. Обеспечивается высокая точность – код имеет небольшие размеры (150 мкм), а медный проводящий слой под подложкой не повреждается.
Маркировка полупроводников
Часто требуется маркировка непосредственно кремния, GaAs, GaN / сапфира или других полупроводников. Маркировка обратной стороны пластин кремния требует очень мелких символов, для чего предпочтительны зеленый или УФ лазеры, так как излучение с длиной волны меньше 1 мкм сильно поглощается в кремнии.
Металлические элементы интегральных схем изготавливаются из олова, серебра, золота и других металлов и так же требуют маркировки. Для маркировки металлов обычно используются лазеры ближнего ИК диапазона.
Разделение пластин на кристаллы - основной технологический процесс в электронной промышленности, который может быть выполнен при помощи лазерного излучения. Метод заключается в нанесении лазером скрайберных рисок на поверхность пластин посредством испарения материала и дальнейшего разламывания по ним. Могут быть разделены стеклянные, керамические, кремниевые, пластины из оксида алюминия, арсенида галлия (GaAs), кремний на сапфире (SoS). Преимущества лазерного разделения заключаются в отсутствии механических напряжений, одностадийности, высоких скоростях процесса. Технология Stealth dicing [1], представляющая собой модификацию кремниевой пластины сканирующим лазерным лучом и последующего разделения ее путем равномерного растяжения подложки. Технология исключает загрязнение пластины продуктами прямой лазерной абляции.
Оптимально, чтобы один лазерный источник подходил для всех перечисленных задач обработки. Таким источником является DPSS УФ лазер. Его излучение хорошо поглощается всеми материалами, используемыми в микроэлектронной промышленности.

1 M. Kumagai, N. Uchiyama, E. Ohmura, R. Sugiura, K. Atsumi and K. Fukumitsu (2007). "Advanced Dicing Technology for Semiconductor Wafer – Stealth Dicing". IEEE Transactions on Semiconductor Manufacturing. 20 (3): 259–265.